Penyelesaian Baharu untuk Penyediaan Spesimen
JIB-PS500i menyediakan tiga penyelesaian untuk membantu penyediaan spesimen TEM. Aliran kerja throughput yang tinggi dijamin daripada penyediaan spesimen hingga pemerhatian TEM.
Ciri-ciri

TEM-LINKAGE
Penggunaan kartrij condong dua kali JEOL dan pemegang TEM* memudahkan hubungan antara TEM dan FIB. Kartrij boleh dipasang pada pemegang spesimen TEM khusus dengan satu sentuhan.
●Aliran kerja pemindahan spesimen dengan kartrij condong dua kali*

* adalah pilihan.
●OmniProbe 400*

OmniProbe 400* (Instrumen Oxford) yang diguna pakai membolehkan operasi dan manipulasi pengambilan yang tepat dan lancar. Operasi OmniProbe 400* disepadukan ke dalam perisian untuk JIB-PS500i.

Spesimen: Peranti semikonduktor peraturan reka bentuk 5 nm (FinFET)
Keadaan cerapan: (Kiri) Voltan pecutan 2 kV, Pengesan SED Imej elektron sekunder,
(tengah dan kanan) Voltan pecutan 200 kV, imej TEM, Instrumen: JEM-ARM200F
SEMAK-DAN-PERGI
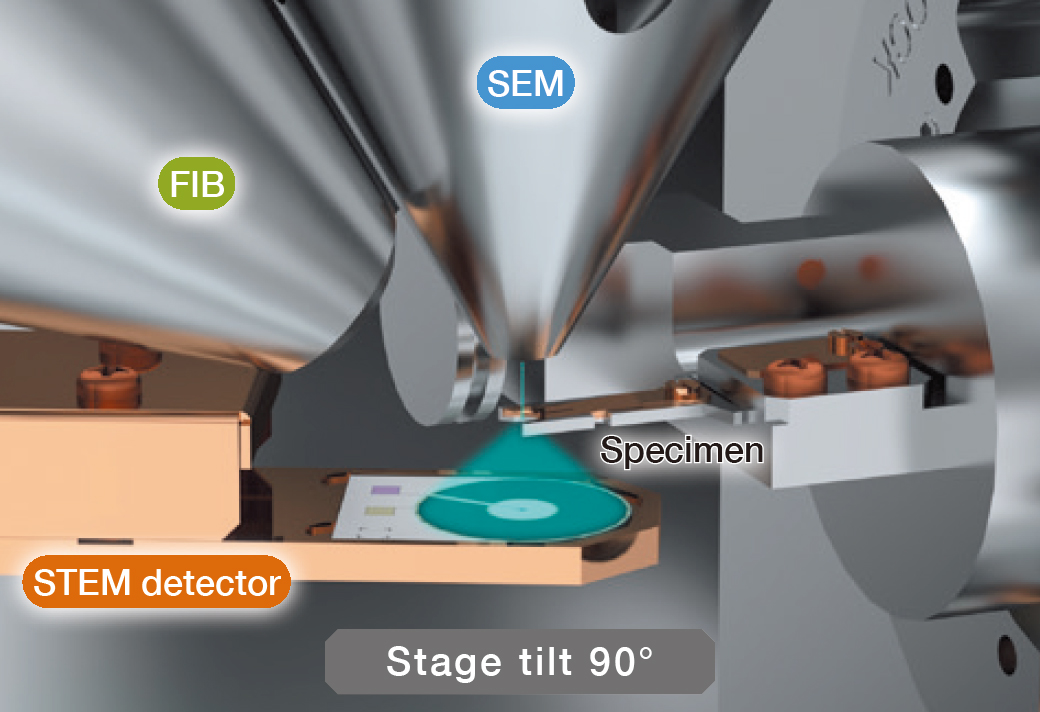
Untuk menyediakan spesimen TEM dengan tepat dan cekap, adalah penting untuk menyemak kemajuan penyediaan dengan cepat. Dengan peringkat kecondongan tinggi dan skema pengesannya, JIB-PS500i membolehkan peralihan yang lancar daripada pengilangan FIB kepada pengimejan mikroskop elektron penghantaran (STEM) mengimbas. Peralihan pantas antara pemprosesan lamella dan pengimejan STEM membawa kepada penyediaan spesimen yang cekap.
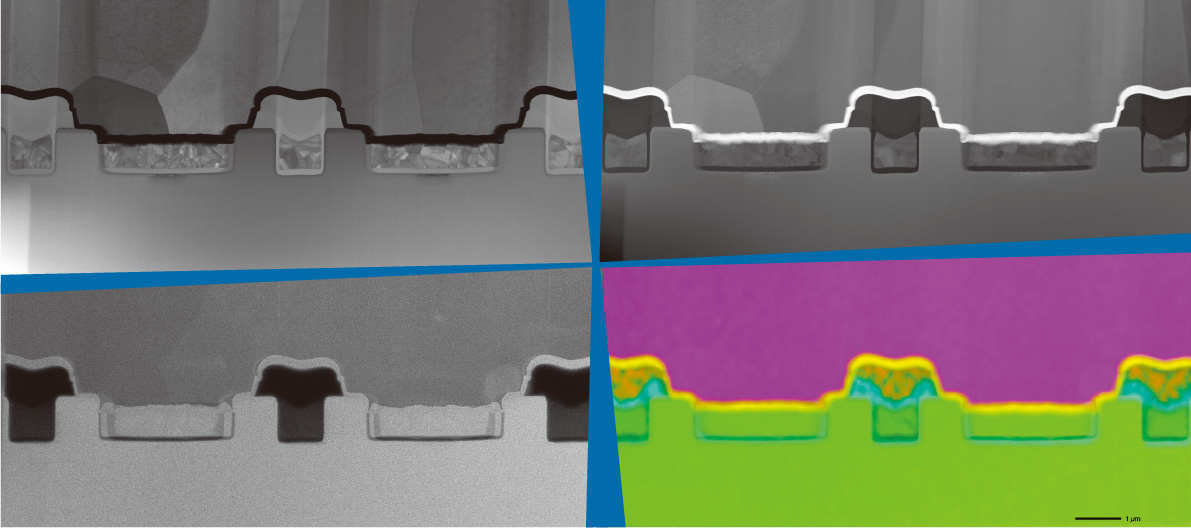
Spesimen: Peranti semikonduktor kuasa SiC Keadaan pemerhatian: Voltan pecutan 30 kV,
Pengesan (Kiri atas) STEM-BF, (Kanan atas) STEM-DF, (Kiri bawah) SED Imej elektron sekunder,
(Kanan bawah) Peta EDS Ungu: Al Kuning: Ti Jingga: P Biru: O Hijau: Si
PERSEDIAAN AUTOMATIK
JIB-PS500i mengautomasikan penyediaan spesimen menggunakan sistem penyediaan spesimen TEM automatik STEMPLING2*. Sistem automatik ini membolehkan mana-mana pengendali menyediakan spesimen untuk TEM dengan lancar.
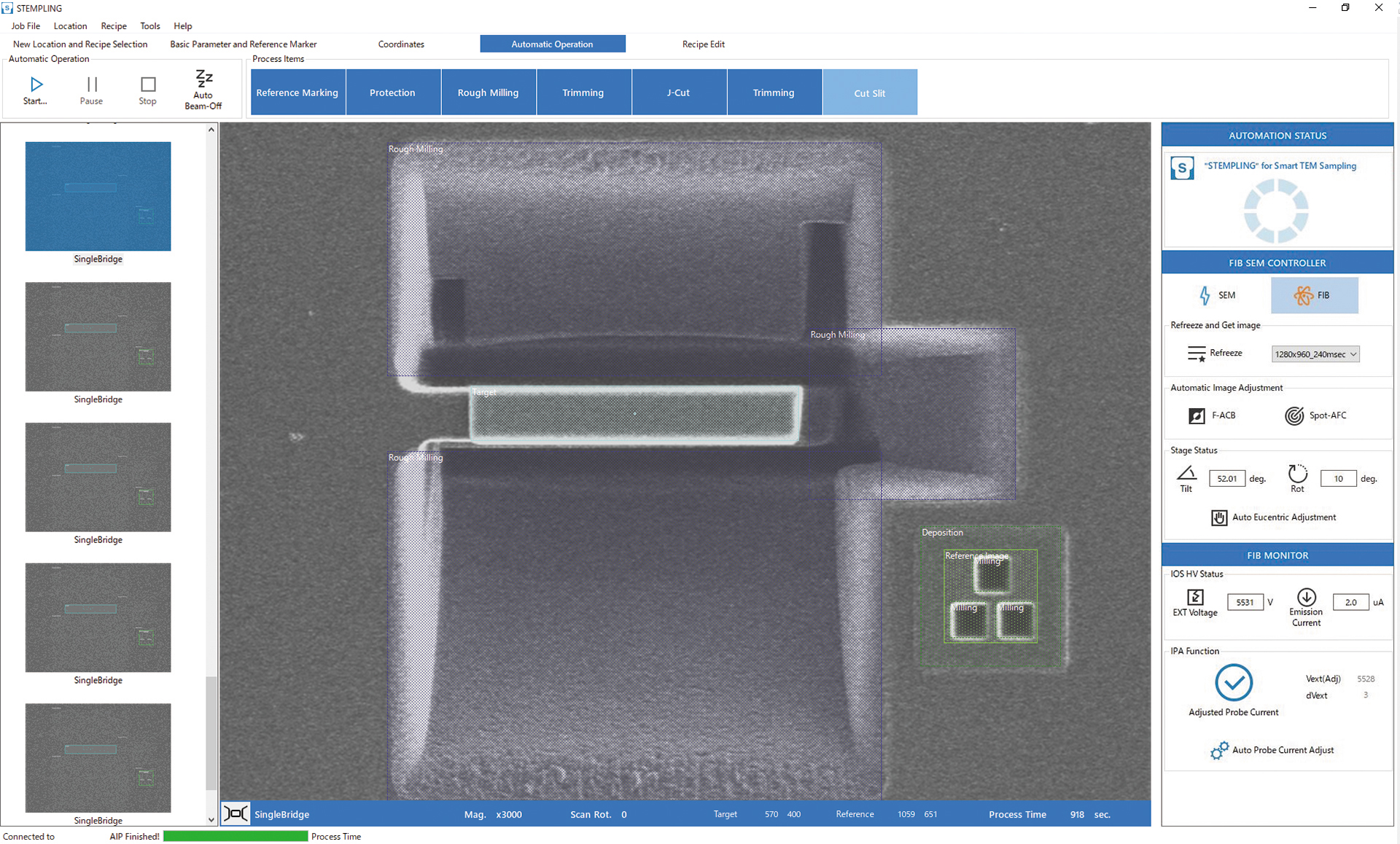
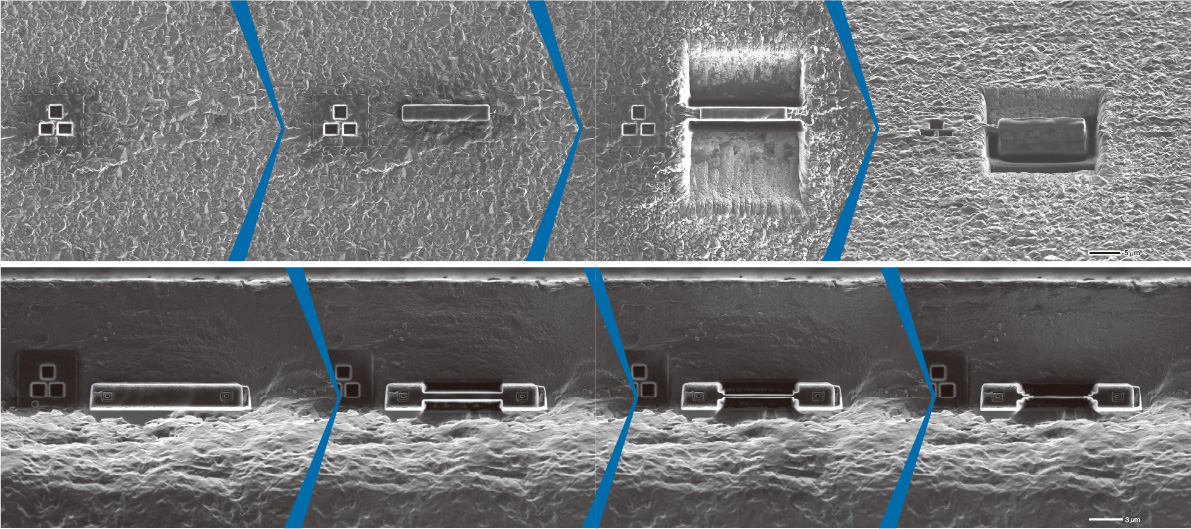
Spesimen: Penyaduran kuprum
(Atas) Penyediaan automatik blok spesimen, (Bawah) Penipisan blok spesimen dengan pemprosesan automatik
Keadaan pemerhatian: Voltan pecutan 30 kV, Pengesan SED (imej SIM)
Pengimejan SEM RESOLUSI TINGGI & KONTRAST TINGGI
Berhenti teragak-agak, berhenti kehilangan titik akhir dalam pengilangan. Imej SEM berkualiti tinggi membantu anda.
Sistem pengesanan isyarat
Pelbagai pengesan tersedia, termasuk SED standard, UED dan iBED. Memilih pengesan optimum membolehkan anda melihat imej tajam pelbagai spesimen di bawah pelbagai keadaan eksperimen.
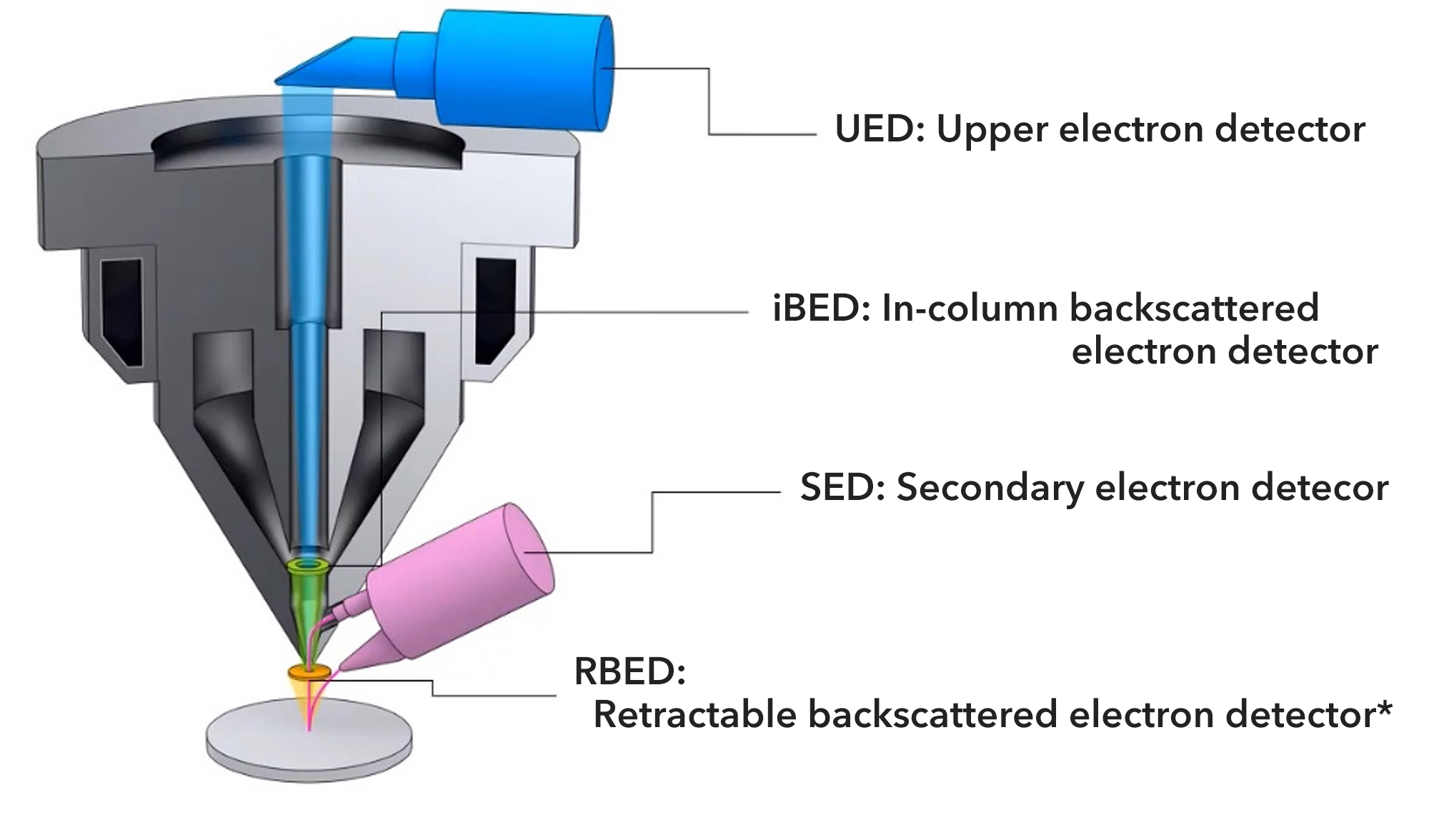
Pengimejan SEM resolusi tinggi
Sistem kanta super kon yang baru dibangunkan dibina ke dalam lajur SEM, meningkatkan prestasi pengimejan pada voltan pecutan rendah. Pengimejan hebat ini sangat berguna untuk menyemak status pengilangan titik akhir spesimen lamela menggunakan SEM.
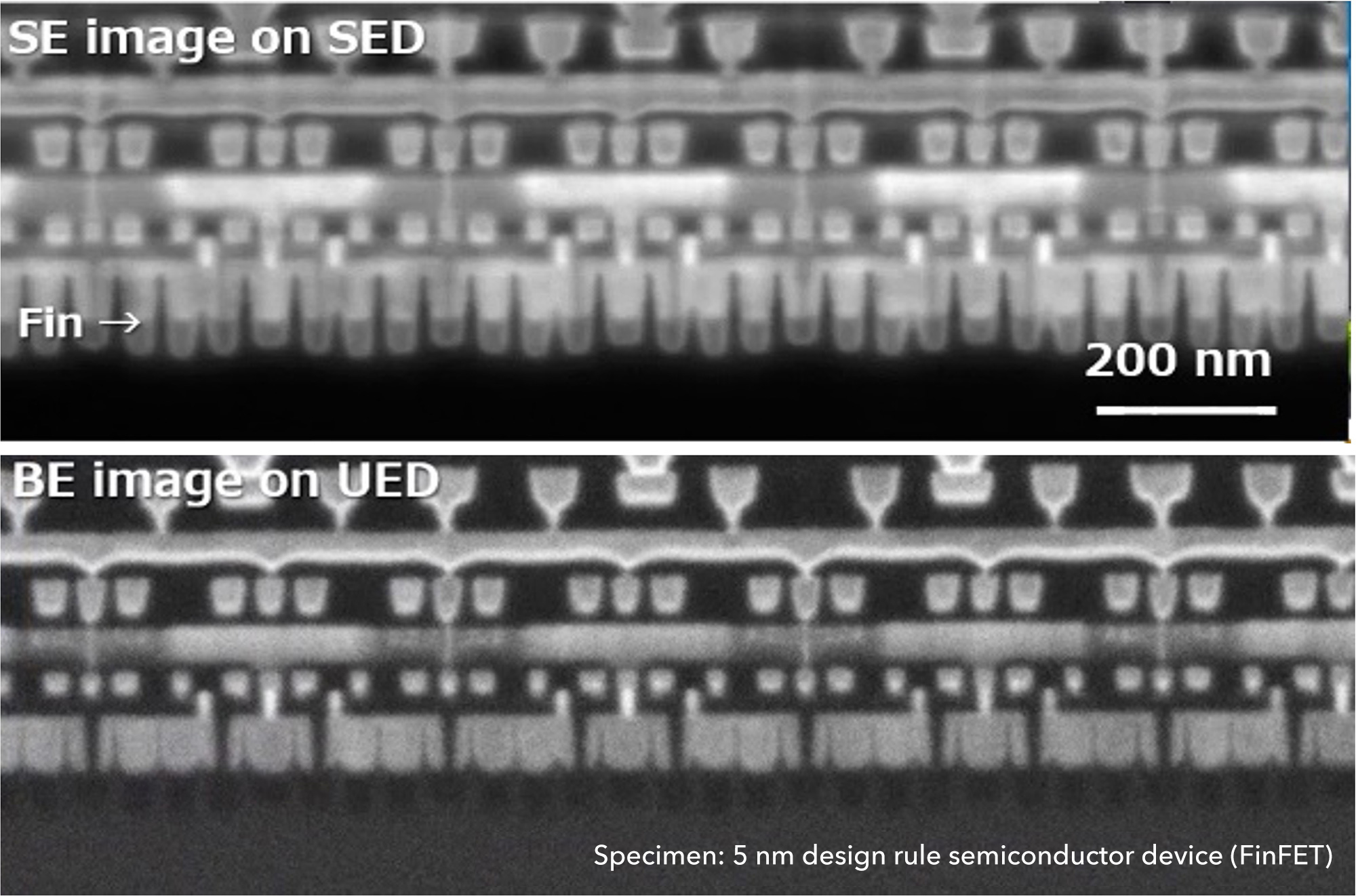
Pengimejan SEM keratan rentas yang disediakan FIB
Pengesan elektron berselerak belakang (RBED)* yang sangat kecil dan boleh ditarik balik boleh digunakan walaupun dengan kecondongan peringkat tinggi. Untuk pengimejan keratan rentas yang disediakan FIB, yang memerlukan kedua-dua permukaan spesimen dan pengimejan condong, gabungan pelbagai pengesan termasuk SED dan UED menjadikannya sesuai untuk pengimejan SEM keratan rentas.

Spesimen: Keratan rentas yang disediakan oleh FIB bagi peranti memori kilat NAND 3D 200 nm
Keadaan cerapan: Voltan pecutan 2 kV, Pengesan (Atas) imej elektron berselerak belakang RBED, (Kiri) imej elektron sekunder SED,
(Pusat) imej elektron berselerak belakang RBED, (Kanan) imej elektron berselerak belakang UED
Perisian integrasi EDS*
Fungsi analisis EDS dibina ke dalam perisian kawalan instrumen utama, dengan itu membolehkan analisis unsur spesimen tanpa menukar perisian. (Ini hanya tersedia apabila instrumen dilengkapi dengan JEOL EDS*.)

Pemprosesan FIB BERKUASA TINGGI & BERKUALITI TINGGI
Untuk penyediaan spesimen terbaik, pemprosesan FIB yang lebih berkuasa.
Pemprosesan FIB yang luas dan pantas
Lajur FIB membolehkan pemprosesan dengan rasuk ion Ga arus besar (sehingga 100 nA).
Pemprosesan arus tinggi ini amat berkesan untuk pengimejan dan analisis kawasan besar.
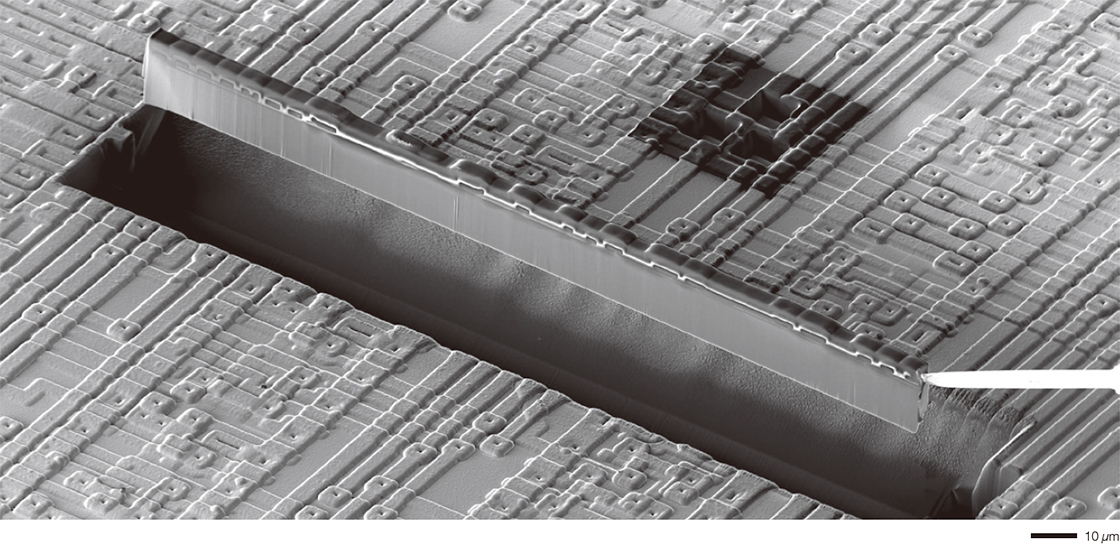
Spesimen: Peranti semikonduktor
Keadaan cerapan: Voltan pecutan 3 kV, Pengesan SED Imej elektron sekunder
Blok spesimen (200 × 4 × 15 μm). Blok spesimen diambil dengan OmniProbe 400*
Pembuangan lapisan kerosakan oleh pemprosesan kV rendah
Lajur FIB ditetapkan kepada jarak kerja yang lebih pendek daripada model sebelumnya JEOL; ini, bersempena dengan bekalan kuasa baharu, telah membawa kepada prestasi pemprosesan yang sangat baik pada voltan pecutan rendah. Penambahan sistem kawalan baharu, menghasilkan keupayaan pengilangan halus berprestasi tinggi yang penting untuk penyediaan lamella yang berkualiti.
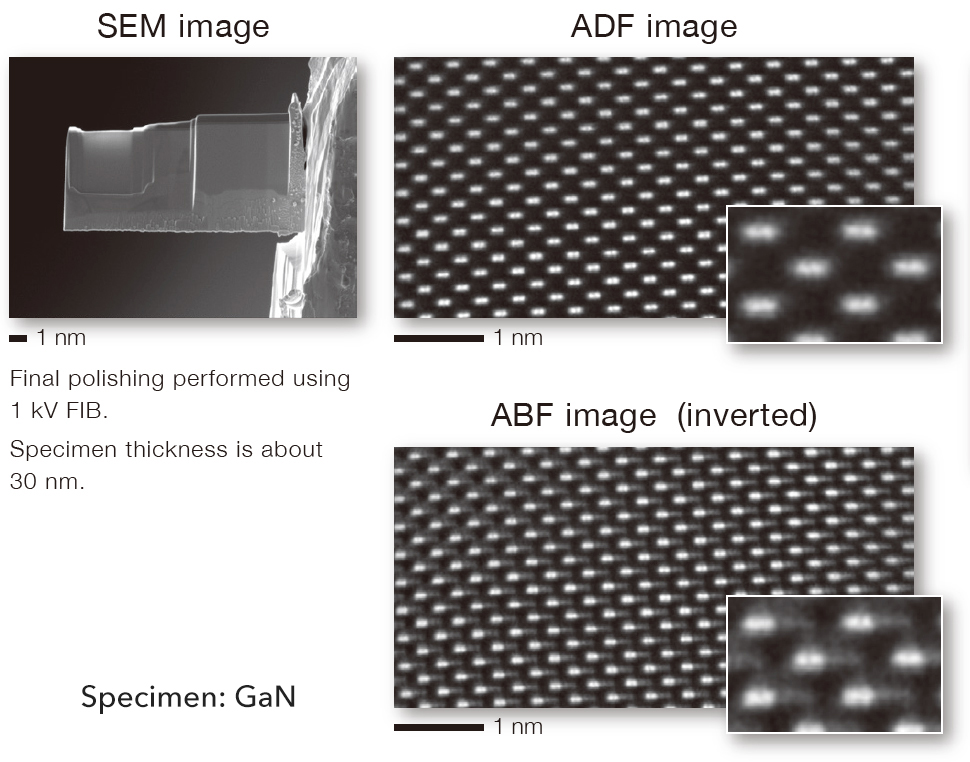
Reka Bentuk Dewan & Pentas Baharu
Sangat fleksibel, kecondongan tinggi & pentas besar untuk memenuhi sebarang keperluan.
Memuatkan spesimen besar
JIB-PS500i menggunakan ruang spesimen yang besar dan pentas motor besar eusentrik penuh 5 paksi yang baru dibangunkan, meningkatkan julat pergerakan pentas sambil menampung spesimen yang besar. Peringkat besar ini membolehkan pemprosesan dan pengimejan keseluruhan permukaan spesimen berdiameter 130 mm. Tambahan pula, sampel dengan ketinggian sehingga 80 mm boleh dimuatkan ke ruang spesimen.

Wafer silikon berdiameter 150 mm dimuatkan ke ruang spesimen.

Enjin AVERT untuk menentukan had pergerakan menggunakan model 3D
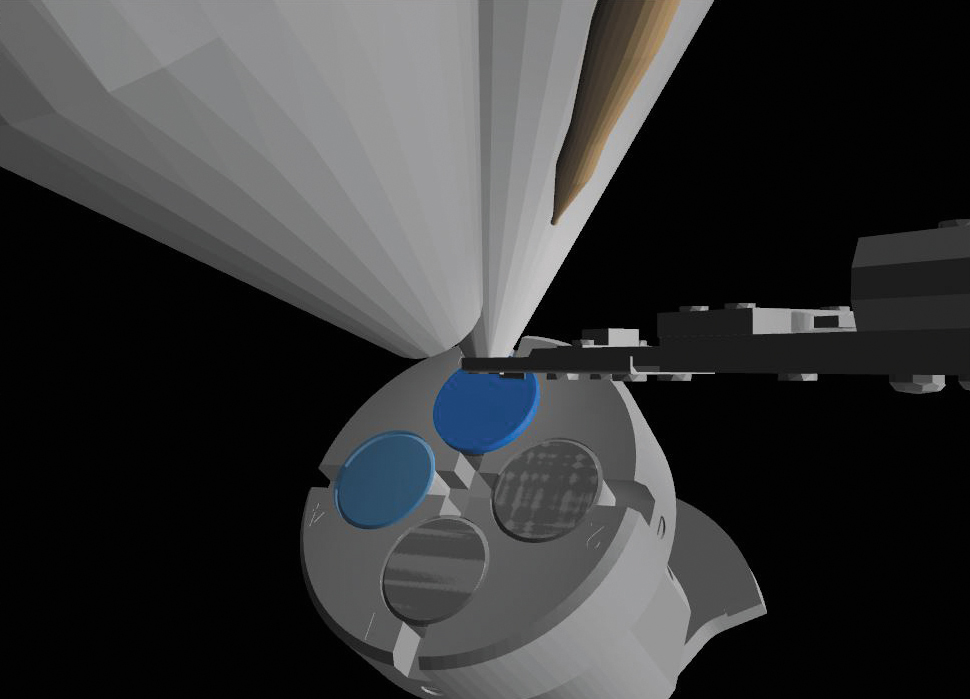
Enjin AVERT digunakan untuk menentukan had pergerakan spesimen menggunakan model 3D pemegang spesimen, pentas dan objek di dalam ruang. Oleh itu, dalam apa jua keadaan, spesimen tidak boleh mengganggu pengesan dan kanta objektif.
* adalah pilihan.
spesifikasi
SEM
| Resolusi imej | 0.7 nm (15 kV) 1.4 nm (1 kV) 1.0 nm (1 kV, mod BD) |
|---|---|
| Pembesaran | ×50 hingga ×1,000,000 (mod STD) ×1,000 hingga ×1,000,000 (mod UHR) ×10 hingga ×19,000 (mod LDF) (saiz cetakan 128 mm × 96 mm) |
| Voltan pendaratan | 0.01 hingga 30 kV |
| Arus rasuk | ~1 pA hingga 500 nA atau lebih |
| Voltan pincang spesimen | 0.0 hingga -5.0 kV |
| Pistol elektron | Pistol elektron pelepasan medan Schottky Plus dalam kanta |
| Sudut apertur kanta kawalan (ACL) |
Terbina dalam |
| Kanta objektif | Kanta penstabilan kuasa |
| Kedalaman yang panjang mod fokus (LDF). |
Terbina dalam |
| Pengesan (standard) | Pengesan elektron sekunder (SED), Pengesan elektron atas (UED), Pengesan elektron terserak belakang dalam kanta (iBED) |
FIB
| Resolusi imej | 3 nm (pada 30 kV) |
|---|---|
| Pembesaran | ×50 hingga ×300,000 (terhad bergantung pada voltan pecutan) |
| Mempercepatkan voltan | 0.5 hingga 30 kV |
| Arus rasuk | 1.0 pA hingga 100 nA, 13 peringkat boleh tukar (30 kV) |
| Bukaan boleh alih | Pemacu motor, 16 peringkat boleh tukar (3 peringkat adalah tambahan) |
| Sumber ion | Ga sumber ion logam cecair |
| bentuk berputar dengan mengisar |
Segi empat tepat, Bulatan, Poligon, Titik, Garisan, BMP |
Tahap spesimen
| Jenis | Peringkat goniometer eusentrik penuh |
|---|---|
| Mengawal | Kawalan komputer, kawalan motor 5 paksi Pengukuran gangguan 3D Enjin AVERT |
| Spesimen pergerakan |
X: 130mm |
| Y: 130mm | |
| Z: 1.0 mm hingga 40 mm | |
| Condongkan: –40.0 hingga 93.0° | |
| Putaran: 360.0° tidak berkesudahan |
Muat turun Katalog
Galeri

Maklumat lanjut
Adakah anda seorang profesional perubatan atau kakitangan yang terlibat dalam penjagaan perubatan?
Tidak
Sila diingatkan bahawa halaman ini tidak bertujuan untuk memberikan maklumat tentang produk kepada orang ramai.